MEMS(微机电系统)是指集微型传感器、执行器以及信号处理和控制电路、接口电路、通信和电源于一体的微型机电系统。
MEMS压力传感器可以用类似集成电路(IC)设计技术和制造工艺,进行高精度、低成本的大批量生产,从而为消费电子和工业过程控制产品用低廉的成本大量使用MEMS传感器打开方便之门,使压力控制变得简单易用和智能化。传统的机械量压力传感器是基于金属弹性体受力变形,由机械量弹性变形到电量转换输出,因此它不可能如MEMS压力传感器那样做得像IC那么微小,成本也远远高于MEMS压力传感器。相对于传统的机械量传感器,MEMS压力传感器的尺寸更小,最大的不超过1cm,使性价比相对于传统“机械”制造技术大幅度提高。
MEMS压力传感器原理
目前的MEMS压力传感器有硅压阻式压力传感器和硅电容式压力传感器,两者都是在硅片上生成的微机电传感器。
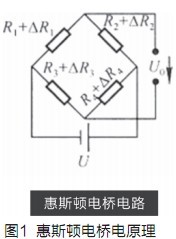
硅压阻式压力传感器是采用高精密半导体电阻应变片组成惠斯顿电桥作为力电变换测量电路的,具有较高的测量精度、较低的功耗,极低的成本。惠斯顿电桥的压阻式传感器,如无压力变化,其输出为零,几乎不耗电。其电原理如图1所示。硅压阻式压力传感器其应变片电桥的光刻版本如图2。

MEMS硅压阻式压力传感器采用周边固定的圆形的应力杯硅薄膜内壁,采用MEMS技术直接将四个高精密半导体应变片刻制在其表面应力最大处,组成惠斯顿测量电桥,作为力电变换测量电路,将压力这个物理量直接变换成电量,其测量精度能达0.01%~0.03%FS。硅压阻式压力传感器结构如图3所示,上下二层是玻璃体,中间是硅片,硅片中部做成一应力杯,其应力硅薄膜上部有一真空腔,使之成为一个典型的绝压压力传感器。应力硅薄膜与真空腔接触这一面经光刻生成如图2的电阻应变片电桥电路。当外面的压力经引压腔进入传感器应力杯中,应力硅薄膜会因受外力作用而微微向上鼓起,发生弹性变形,四个电阻应变片因此而发生电阻变化,破坏原先的惠斯顿电桥电路平衡,产生电桥输出与压力成正比的电压信号。图4是封装如IC的硅压阻式压力传感器实物照片。



